欢迎光临深圳市兰圣科技有限公司网站!
- 我们专注于IC现货行业20年!
你会认为 AMD 的 Instinct MI300X 和 Nvidia 的 B200 GPU 很大吗?请再想一想!
台积电在其北美技术研讨会上宣布,正在开发其基板芯片(CoWoS)封装技术的一个版本,该技术将使系统级封装(SiP)比现有尺寸大两倍以上。这些将使用120x120mm²的巨型封装(与吐司面包片大小相当),并将消耗数千瓦的电力。
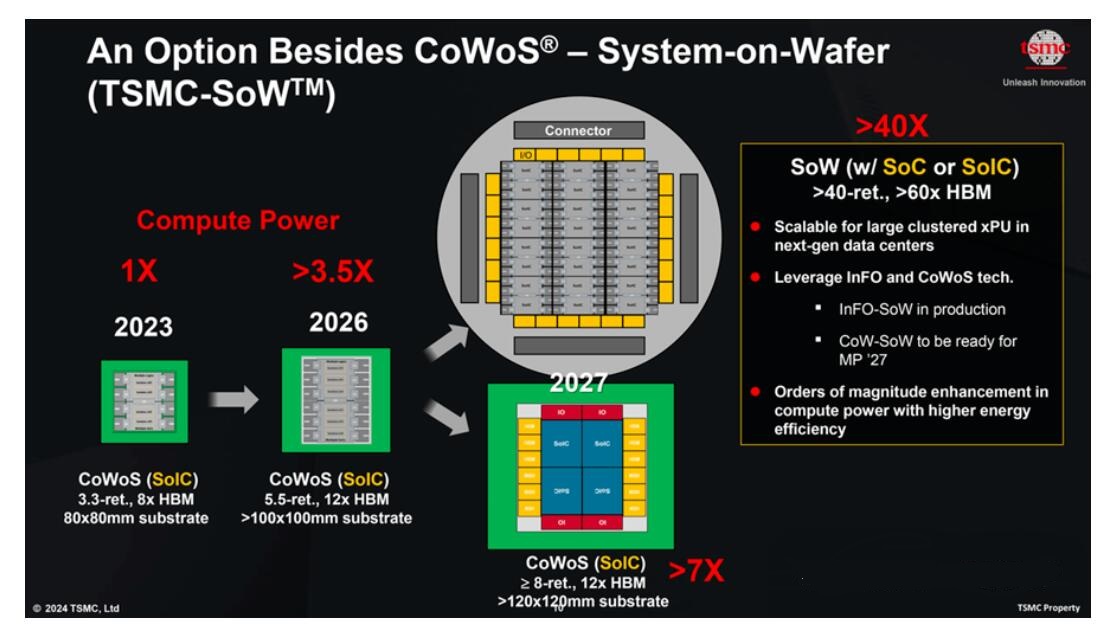
现有的最新版本的CoWoS允许台积电构建比光掩模尺寸(或十字线,858mm2)大出约3.3倍的硅中介层。因此,逻辑、8 个 HBM3/HBM3E 内存堆栈、I/O 和其他小芯片最多可以占用 2831mm²。AMD 的 Instinct MI300X 和 Nvidia 的 B200 使用了这项技术,尽管 Nvidia 的 B200 处理器比 AMD 的 MI300X 大。
下一代 CoWoS_L 将于 2026 年投入生产,能够实现约现有尺寸的 5.5 倍,这意味着 4719mm²可用于逻辑、多达 12 个 HBM 内存堆栈和其他芯片。此类 SiP 还需要更大的基板,根据台积电的PPT,我们将看到 100x100mm²的基板。因此,此类处理器将无法使用 OAM 模块。
台积电不会止步于此:到2027年,它将拥有CoWoS技术的一个版本,该技术将使转接层的尺寸达到八倍或更多,这将使小芯片的空间达到6,864mm²。台积电设想的其中一种设计依赖于四个堆叠的系统集成芯片(soic),搭配12个HBM4内存堆栈和额外的I/O芯片。这样一个庞然大物肯定会消耗大量的电力——将会达到数千瓦,并且需要非常复杂的冷却技术。台积电还希望这种解决方案使用120x120mm²的基板。
有趣的是,今年早些时候,博通公司展示了一款定制的人工智能处理器,它拥有两个逻辑芯片和 12 个 HBM 内存堆栈。我们没有这款处理器的规格,但它看起来比 AMD 的 Instinct MI300X 和 Nvidia 的 B200 更大,不过没有台积电计划在 2027 年推出的那么大。
深圳市兰圣科技有限公司
服务热线:400-886-3282
地址:深圳市福田区深南中路3006号佳和华强大厦B座3011